电子行业是有限元分析应用的一个重要领域。随着全球电子工业的飞速发展,电子产品的设计愈来愈精细、复杂;市场竞争要求电子产品在性能指标大幅度提高的同时,还要日趋小型化。电子产品跌落、新型电子材料的研发和制造、音频设备声场特性的设计和评估、电子产品的热力仿真、芯片封装的热分析等的力学仿真是电子领域中很深入、复杂并极具挑战性的课题,需要多门学科的理论和方法的综合应用。
针对电子领域关注的各种线性、非线性、热力耦合,湿热耦合,跌落、开裂等力学问题ABAQUS有针对性的提供了相应的有限元分析解决方案。ABAQUS的有限元分析能力已经被全球各大电子生产和设计单位所检验并得到了广泛的认可。
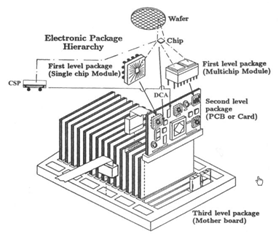
电子封装分为零、一、二、三共四个等级,四个等级中,ABAQUS都有广泛的应用:
零级:芯片级连接: 例如, 金和焊料凸点, 球焊 (热控制, 焊料疲劳, 加工过程模拟)
一极:单芯片或多芯片模块 (热控制, 焊料疲劳, 翘曲, 加工过程模拟)
二级:印刷线路板 (翘曲, 热控制, 振动响应)
三级:主板和全部外套 (连接器设计, 振动响应, 装配件设计, 跌落)
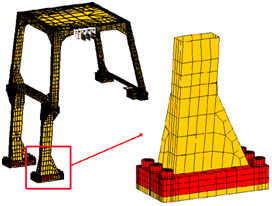
ABAQUS软件被广泛用于机械,电子,土建等领域的抗震和冲击方面的分析。在进行震动和冲击方面的应用中,ABAQUS的优势最大体现在结合了隐式求解器和显式求解器的优点:
隐式求解器ABAQUS/Standard适于进行基于频域的动力学分析:自振频率提取(对大规模模型可以采用并行的Lanczos特征值提取器),模态动力学,基于模态和直接积分的稳态动力学分析,随机响应分析,响应谱分析等等。以上所有分析可以基于线性或者非线性的状态进行(如考虑结构预载荷的频率提取分析),通过step by step的分析方法来实现多步骤的分析,其中模态动力学可以考虑较弱的非线性效应。结构基础的位移,速度或加速度可以设置成随时间变化(模态动力学)或随频率变化(稳态动力学)。除此之外,Standard还提供了在时域上积分的隐式动力学分析和复频率提取分析。
显式求解器ABAQUS/Explicit适于进行基于时域的动力学分析:该方法尤其适于高度非线性的震动和冲击问题的分析,如考虑塑性,接触,材料失效等效应的问题。该方法可以在时域上精确地捕捉结构的响应历程,但所消耗的计算机资源比基于模态的动力学要大许多。对于大规模模型,可以采用基于域分解的单机多CPU和多机并行(MPI)功能来加速的显式积分的求解速度。
由于以上两个求解器均为ABAQUS自己开发的产品,二者的结合非常紧密,其输入文件的语法格式完全一致。在前后处理模块ABAQUS/CAE中,还允许用户对同一有限元模型方便地在这两种分析方法中切换,并保留以前分析中定义好的载荷,接触,边界条件等内容,这为用户对同一个问题采用不同算法进行分析提供了方便的途径。

ABAQUS还可以方便的进行子模型的分析,并且隐式和显式求解器均支持该功能。这对大规模模型的震动分析很有帮助:整体模型的网格可以比较粗进行结构整体响应的分析,而最可能发生破坏的地方局部需要进行网格加密,可以作为一个子模型单独进行分析而把整体计算的结果作为边界条件施加到子模型上。
ABAQUS提供了丰富的材料模型库,用户可以方便的选择包括金属,工程塑料,泡沫材料等多种材料本构模型,可以考虑材料的塑性,损伤,失效,温度相关等非线性效应,用户还可以利用ABAQUS的用户子程序的功能进一步添加自己所需要的材料模型。
ABAQUS提供了丰富的单元库,其中的实体壳单元(SC8R,SC6R)可以让用户不必抽取中面就能够模拟薄壁结构的相互接触作用,并允许单元的边长比很大;修正的二阶十节点四面体单元(C3D10M)允许用户快速的划分网格并确保单元的计算精度很高;连接单元库(connector elements)提供了广泛的机构连接方式来模拟各种机构部件之间的连接关系,如铰接,焊点,万向接头等,甚至可以考虑连接单元的失效来模拟机构部件在震动和冲击作用下互相之间的脱开。
ABAQUS提供了广义刚体功能,模型中的任何一部分允许是变形体,也允许是刚体,甚至是显示体(仅显示出模型的形状不参与有限元计算),这就为大规模模型的动力学计算提供了方便的途径,用户可以仅把最关心的模型部位作为变形体,而其他部位作为刚体,当初步的分析完成后,可以再一步一步把刚体转化成变形体,最终获得符合实际的结果,该功能使得用户对分析过程的控制非常方便。
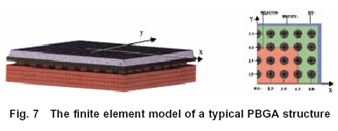
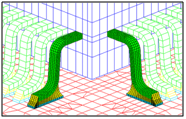

由不同材料组成的封装组件在温度变化的环境下会产生很大的热应力,导致封装失效。ABAQUS具有强大的热固耦合分析功能,包括:稳态热传导和瞬态热传导分析,顺序耦合热固分析,完全耦合热固分析,强制对流和辐射分析,热界面接触,热电耦合等等。可以定义从简单弹塑性模型到随温度变化材料常数的热塑性、热硬化性、高温蠕变等复杂材料模型,来模拟金属、聚合物、复合材料等电子材料的热学和力学性质。
ABAQUS包括51种纯热传导和热电耦合单元,83种隐式和显式完全热固耦合单元,覆盖杆、壳、平面应变、平面应力、轴对称和实体各种单元类型,包括一阶和二阶单元,为用户建模提供极大的方便。而其他通用有限元软件对应的热分析单元数量都比ABAQUS少,如ANSYS中纯热传导和热耦合单元总计为40种,MARC中纯热传导单元为40种,无完全热固耦合单元。右图是台湾新竹清华大学采用ABAQUS分析BGA焊点热应力和热应变的模型图。
ABAQUS还是世界上各大汽车厂商分析发动机中热固耦合和接触问题的标准软件,如奥地利著名发动机生产商AVL在自己的发动机分析软件AVL.Excite中嵌入ABAQUS作为求解器。下图为采用ABAQUS分析得到的某电路板的温度场分布云图。
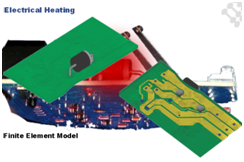

典型应用:塑料、陶瓷、金属封装等各种封装组件在温度载荷下的变形和受力、IC芯片和基板之间的导热、封装材料界面间的热传导、板上元件的强制对流散热、散热片通过空气的辐射散热等

由于受热导致的应力和应变在温度循环下会造成封装材料疲劳失效,如倒装焊中的焊点和表面贴装中的引线热疲劳问题。ABAQUS/Standard中的直接载荷循环分析功能提供了预测承受热载荷的弹塑性结构的低周热疲劳寿命。更复杂的疲劳问题可以通过ABAQUS/Safe模块来实现。右图是NEC公司和纽约州立大学Buffalo分校电子封装中心合作采用ABAQUS进行表面贴装中共晶焊点热疲劳失效分析的结果。
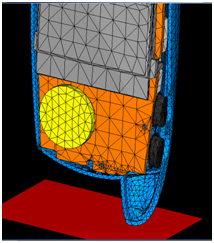
深入研究个人手持电子产品的冲击和跌落问题是具有挑战的工作。难点来源于:
复杂的几何体:典型的组成包括材料为 (1mm厚)热塑塑料的前后薄壁外壳,两个或更多个印制电路板(PCB)、连接件、钣金片、橡胶垫、电池、金属弹簧和一个LCD显示屏,PCB板是三明治结构,由2到6个螺钉固定。
许多元件间的接触作用:各个元件置于主PCB板和前后外壳之间,由粘接剂或铆头固定,各个元件之间和内壁会发生接触。 以上结构为薄壁结构,传统方法采用壳单元模拟。但从CAD软件中导入的模型中往往包括上千个表面,提取中面并划分壳单元是一个需要高技巧和丰富经验,并且非常耗费时间的工作。然而划分四面体的实体单元可以在有限元软件中自动完成,并且只需要几分钟。在这样的情况下需要选择精度和可靠性都很高的四面体单元。
跌落和碰撞问题一般需要采用显式动力学方法进行求解,考虑装配预应力的跌落和碰撞分析需要结合隐式和显式的方法进行求解。ABAQUS/Standard和ABAQUS/Explicit中均提供10结点的修正四面体单元,模拟接触问题精度很高,并且两个求解器的模型可以无缝转化,这样为进行冲击和跌落分析提供了一种快捷、精确的方法。所以世界上重要手机生产商如摩托罗拉、诺基亚等都首选ABAQUS作为跌落和碰撞分析的求解器。右上图为摩托罗拉公司手机跌落分析模型。

各级封装组件,如圆片的划片、切边,金属封装中的钎焊、退火,塑封中焊球的回流、固化,薄膜材料涂层等过程均是复杂的机械加工过程,研究其中的制造残余应力,结构翘曲是很重要的工作。ABAQUS中强大的接触、单元生死、退火成形分析、蒙皮建模、子模型等功能可以有效的模拟各种制造过程。下图为新加坡微电子学研究所采用ABAQUS子模型的功能研究BGA封装焊点的全局模型和研究局部细节的子模型网格图。
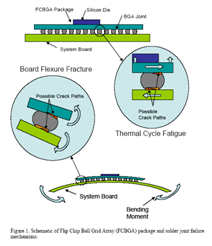
ABAQUS的断裂力学分析功能在商业求解器中是国际上公认的最强的,并且不断在客户推动下发展,最新功能包括粘结单元和虚拟裂纹闭合技术等工程断裂分析技术。此外,ABAQUS可以很方便的进行材料剪切、拉伸、屈曲等工况下失效的模拟。这样为模拟芯片,模塑料等封装组件开裂问题提供了有力手段。右图是Intel公司和ABAQUS合作,利用粘结单元模拟焊球和基板之间的开裂,对母板生产厂商提供设计标准。
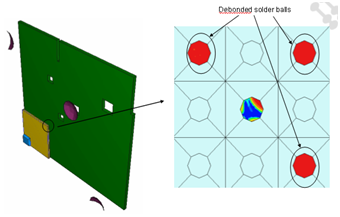
ABAQUS不光有断裂力学分析功能,而且在客户推动下,最新功能包括粘结单元和虚拟裂纹闭合技术(VCCT)等工程断裂分析技术。下图是Intel公司做的PCB板的弯曲,焊点失效。
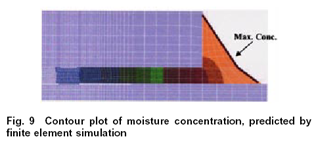
模塑料、下填料等高分子材料在潮湿环境下会吸收水汽并胀大,造成封装开裂、漏气等。ABAQUS中具有很强的质量扩散分析和土壤渗流和混凝土固结分析功能,其力学本质和湿应力问题类似,借助这些分析功能可以有效的解决热-湿-固三场耦合分析问题。上图是Nokia公司、马里兰大学CALCE封装中心和Philips公司合作用ABAQUS计算下填料(Underfill)中潮气扩散导致的湿应力问题的结果。

MEMS、麦克风和手机等封装组件中都需要进行声场和声固耦合的分析,ABAQUS拥有强大的声场和声固耦合分析功能,对结构采用固体单元,对空气采用声场单元进行声固耦合的分析,右图是手机内部空气的声压分布云图。
整个模型部件均以壳体单元模拟。 包括后壳,显像管,前壳三部分,另外添加两个质量单元,显像管质量为17Kg整个模型总体质量为35Kg。前后壳为HIPS塑料,显像管为玻璃材料。在前后壳以螺栓及卡扣相连接,显像管与前壳以螺栓连接。分析的目的是找出电视机的共振点,合理优化设计,降低振动响应,下图是结构的三阶阵型及频率响应结果。
 |
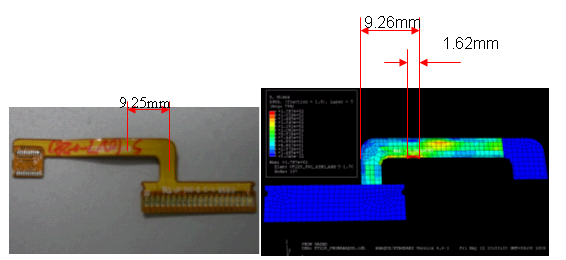
FPC是手机中比较容易发生破坏的不见之一,为破坏分析更加准确,本算例结合FPC的实际结构,应用双层层结构来模拟FPC模型,材料模型选用五层二维各向异性层材料模型,并在层材料上采用分区处理以更加准确的模拟FPC的铜线层,分析结果如下。
目前 Nokia 正在积极探讨基于MOLDFLOW分析结果的结构分析,并以Nokia 6230 mid housing 为例如图37所示,探讨了浇口位置、填充速度、填充材料对模型扭曲的影响,并积极研究将MOLDFLOW的分析结果应用与手机的整机跌落分析中。
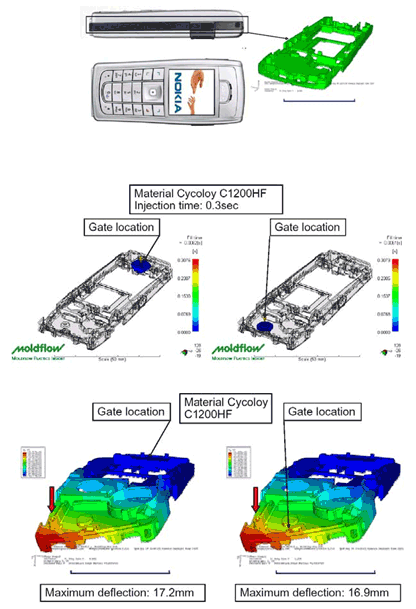 |
通过对天线的CAE仿真分析可以验证天线弹片的应力,接触力,以判断天线弹片的变形是否达到塑性变形,计算出弹片接触PCB板时的变形,并将其倒入CAD中确定天线接触的PAD点的位置及形状。图29为天线实物模型,图30为天线的ABAQUS模型,图31为天线的变形情况,图32为节点的位移曲线。
 |
© 2023 - Copyright WESEE - All Rights Reserved Designed by GreatMo 沪ICP备14034845号-1